Využití 3D či vrstvených pamětí typu DRAM máme v PC světě spojeno především s firmou AMD. Ta se jako jediná odhodlala je v podobě HBM nabídnout i běžným spotřebitelům a nyní hledá cesty k jejich účinnějšímu chlazení.
Vedle neustálého vývoje pokročilejších výrobních technologií, které jsou schopny na stejnou plochu umístit více prvků a výsledný čip provozovat při nižším napětí s celkově nižší spotřebou, je dnes nutné se poohlížet i po jiných způsobech pro zajištění celkového pokroku. Jedním z takových je vrstvení čipů, na což v případě samotných paměťových buněk už dávno přišli výrobci pamětí NAND Flash a my bychom si bez toho dnes jednoduše nemohli kupovat 1TB SSD už za ceny kolem 3000 Kč.

Intel už se také probudil a chystá vrstvené čipy Foveros, a to už na aktuální rok, přičemž co se týče pamětí DRAM, v jejich případě máme vrstvení spojeno především s typem HBM. Tyto paměti neudivují svými takty, však 1 GHz není na dnešní dobu nic, ale dohání to svou obrovskou šířkou rozhraní, a sice 1024 pinů na jeden jediný čip.
Nízké takty umožní provoz takových pamětí s přijatelnou spotřebou a výdejem tepla, což je zvláště důležité především při jejich vrstvení, neboť vrstvy blíže k chladiči sice mohou být chlazeny dobře, ale ty nižší se už mohou hodně potit. V případě budoucích produktů tak bude třeba vymyslet nový přístup k chlazení, o čemž se už v případě Foveros Intel zmínil. V jeho případě budou níže umístěné čipy uloženy pod jistou "vaničkou", jejíž tlusté okraje budou sahat až na heatspreader či styčnou plochu chladiče. V této vaničce pak budou umístěny další čipy, které tak teplo ze spodních vrstev bude moci obejít. Jak to ale chce řešit AMD?
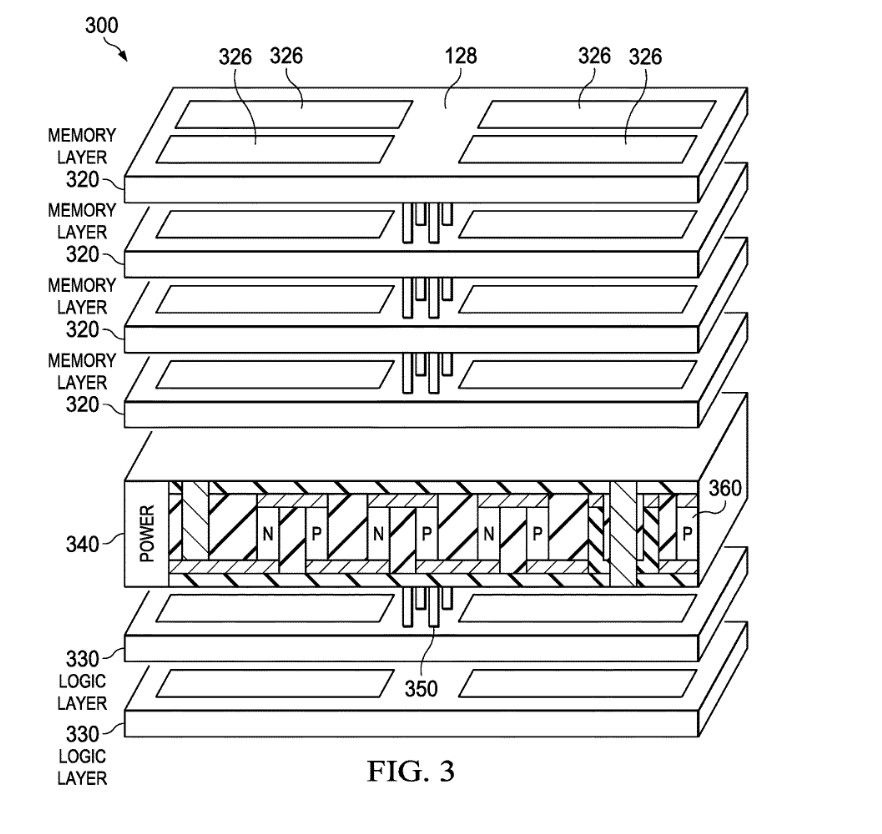
Předem je třeba říci, že zatím jde pouze o patent, od nějž je k reálnému produktu ještě velice daleko. Nejzajímavější je tento první nákres, na němž vidíme vrstvený čip propojený vertikálními datovými spoji (TSV), přičemž spodní vrstvy obsahují logické obvody (čili CPU, GPU, apod.) a vrchní vrstvy jsou paměťové.
Mezi nimi pak vidíme tlustou vrstvu s postranním napájením a částmi označenými jako N a P, takže modří jistě již vědí, že půjde o termoelektrický, neboli Peltierův článek. Ten dokáže po přivedení napětí jednu svou stranu ochlazovat, ovšem na úkor zahřívané opačné strany. Změnou polarity lze určit, která strana se bude ochlazovat a která zahřívat, čili kam bude teplo "pumpováno".

Jde o zajímavé řešení, které však zatím nic neříká o praktické implementaci. Nedozvíme se, kam má teplo směřovat dál. Těžko mohou být chlazeny obě strany čipu, když ten musí být někde napojen na desku a diagram přitom zahrnuje i možnost aktivního přenosu tepla z vrchních paměťových vrstev dolů k logickým. Nicméně jde jen o patent, ne o návrh čipu.
Zcela zřejmý je ale fakt, že takové chlazení nebude pracovat zadarmo. Pelitery potřebují energii a aby měly nějaký efekt, nebývá to zanedbatelný objem. Takže uvidíme, zda se s něčím takovým vůbec setkáme v praxi.



















