Samsungu se povedlo posunout technologii 3D-TSV (Through Silicon Via) opět o něco dále a nyní dokáže propojit 12 vrstev čipů najednou. Rozměry přitom zůstávají shodné s původními 8vrstvými pamětmi.
Společnost Samsung je předním výrobcem paměťových technologií a nyní se mu podařilo udělat další průlom v 3D-TSV (Through Silicon Via) pamětech. Prozatím vyráběl nanejvýš 8vrstvé paměti, které byly propojeny vertikálními spoji uvnitř čipů, nyní ale tento počet navýšil na 12 vrstev. Těchto 12 DRAM čipů je vzájemně propojeno 60 tisíci vertikálními spoji, které mají tloušťku ekvivalentní 1/20 tloušťky lidského vlasu. Výhodou vnitřních propojení je vyšší rychlost komunikace i nižší spotřeba elektrické energie.
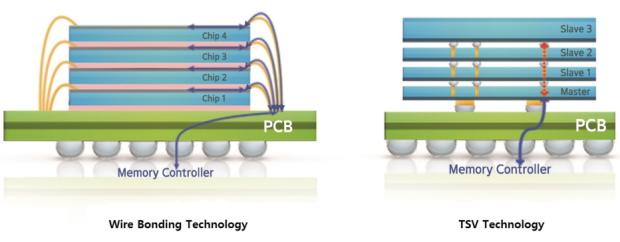
Další výhodou nových čipů je také to, že si zachovávají stejnou tloušťku 720 μm jako původní 8vrstvé varianty, takže zákazníci, kteří využívají stávající 8vrstvé High Bandwidth Memory-2 (HBM2) čipy, mohou přejít na nové bez zásadní změny návrhu svých řešení. Samsung navíc pracuje na čipech, kde má jedna vrstva zvýšenou kapacitu na dvojnásobek, takže z dnešní kapacity 8 GB (8Gb × 8 vrstev) se bude možné dostat až na 24 GB (16Gb × 12 vrstev). Samsung si od nových pamětí slibuje také větší zastoupení v aplikacích umělé inteligence a HPC.