Seznam kapitol
Dnes se podíváme na novinky z oblasti výrobních technologií, fotolitografie a z dalších oblastí čipového průmyslu. Vývoj se žene vpřed, a tak se v budoucnu kromě 32nm výrobní technologie a nových materiálů zřejmě dočkáme i několikrát odložených 450mm waferů.
Jak již zaznělo v titulku, dnešní článek bude zaměřen na trendy z oblasti čipového a procesorového průmyslu. Intel nedávno uvedl 45nm generaci procesorů řady Core a i další výrobci pokračují v zavádění stále měnších výrobních technologií. Začneme trošku netradičně litografií a ozařováním waferů, protože právě technologie fotolitografie a vytváření miniaturních struktur s téměř neskutečnou přesností a minimem defektů přináší další zmenšování výrobních technologií a menší a menší tranzistory...
Trendy v oblasti fotolitografie
Začneme zlehka, zopakováním principů fotolitografie. Procesor vzniká postupným nanášením vrstev na wafer (křemíkovou oplatku). Wafer a vypěstovaná vrstvička SiO2 je pokryta za pomocí fotorezistu (i s použitím dalších materiálů), kde se vrstvu za vrstvou postupně nanáší a chemicky a dalšími postupy po ozáření daných oblastí, opět částečně odstraňuje - tam, kde se určité oblasti do waferu vysvítí přes fotolitografickou masku vzory (možný je i opačný postup, kdy se odstraní neozářené oblasti), po odstranění fotorezistu postupně vznikají tranzistory budoucímo mikroprocesoru. Čím dál větším problémem je ale vlnová délka použitého záření, které se pro takový postup používá.
V roce 1980 se používala k ozařování vlnová délka 463 nm. S postupem času samozřejmě docházelo k jejímu zmenšování. Vlnovou délkou 248 nm například Intel používal do 90nm výrobní technologie, ale v řadě odvětví se stále běžně používá (stejně jako řada předchozích generací fotolitografických zařízení). Pro nejmodernější procesory se ale již jedná o nedostatečnou technologii. Dnes nejběžnější vlnová délka používaná pro výrobu procesorů a osvěcování waferů má vlnovou délku 193 nm, ale i ta je již dávno za velikostí běžně tvořených struktur. Jak se již mnohokrát ukázalo, nástupce 193nm vlnové délky se díky novým postupům podařilo již několikrát oddálit.

Intel a "Tic-Toc" strategie zavádění nových výrobních technologií - 193nm vlnová délka ještě neřekla své poslední slovo (s nasazením nových výrobních technologií počítá v obdobném časovém horizontu, nebo s mírným zpoždením, prakticky celý polovodičový průmysl); s 45 nm a "suchou" DUV bude vznikat i jádro Nehalem, zdroj: Intel
Pro prodloužení životnosti stávajícím zařízením pro litografii s vlnovou délkou 193 nm se používá řada složitých postupů, interference záření, metoda vícenásobného osvitu, speciální fotoresisty a další materiály a technologie. Tak zvanou "suchou" DUV litografii používá například Intel i u současné generace 45 nm procesorů Penryn. Vzhledem agresivní obměně výrobních technologií a požadované změně přibližně každé dva roky, již DUV ale neúprosně dochází dech. Před nasazením dalších technik jako EUV nebo nanotisku bude zřejmě nevyhnutelné použití ponořené fotolitografie.
Imerzní fotolitografie
, krátce označovaná jako DUVi, používá mezi soustavou čoček a křemíkovým waferem, který budeme ozařovat,
kapalinu
- proto hovoříme o "ponořené" litografii. Zde si dovolím citaci z mého staršího článku, kde zmiňuji vzorec pro jednoduchý výpočet možností fotolitografie vzhledem k použité vlnové délce, a tím i možného rozlišení:
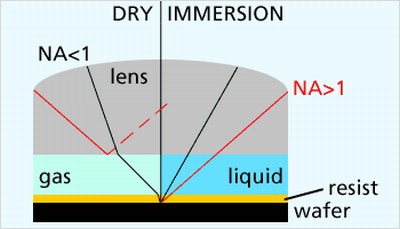
Rozlišení je dáno vztahem:
r = k x λ
(vlnová délka) /
NA
Numerická apertura (NA, Numerical Aperture):
NA = n x sinθ
n
je refrakční index (bod lomu) nejčastěji mezi čočkou a waferem, kterým prochází záření (n je za normálních okolností 1,0, protože médiem je u běžné fotolitografie vzduch). Pokud je refrakční index 1, teoreticky NA je méně než 1 a ve většině případů je prakticky nižší než 0,9, vzhledem k θ, což je maximální úhel dopadu světla pro imerzní fotolitografii (s použitím vody například okolo θ = 65°).
k
je index zavislý na konkrétním zařízení pro fotolitografii. Je to v podstatě soubor technických prostředků dnes umožňující nasazení "suché" DUV litografie i za hranicí vlnové délky použitého záření. Index k je tedy závislý na dalších metodách, které je schopné aplikovat zařizení pro litografii, jako je osvit pomocí dipólu a další.
Použití kapaliny mezi waferem a soustavou čoček přináší dvě zásadní výhody. Zvýší se hloubka ostrosti (DOF, Depth Of Focus) pro danou numerickou aperturu, a co je ještě podstatnější, ponoření dovolí dosažení NA s hodnotami podstatně většími než 1,0 a to má samozřejmě příznivý vliv na dosažitelné rozlišení. Ponoření waferu pod kapalinu dovoluje proto vytvářet struktury s vyšším rozlišením, za použití stejné vlnové délky záření oproti "suché" DUV fotolitografii.
Pro vyplnění mezery se používá extrémě čístá voda nebo další kapaliny, které mají požadované vlastnosti. Kapalina samozřejmě nesmí (a nebo zcela minimálně) pohlcovat použité záření - wafer musí být kapalinou rovnoměrně pokrytý, v kapalině nesmí být žádné bublinky a musí umožnovat rychlé ozařování waferu. K problémům imerzní fotolitografie patří vyšší množství defektů (problémy s rovnoměrnou distribucí kapaliny, mikropřemostění, mikrobublinky a další). DUVi tak přináší vyšší rozlišení, ale také mírně nižší výkon WPH (Wafers Per Hour, počet zpracovaných waferů za hodinu) oproti suché fotolitografii a za vyšší cenu.
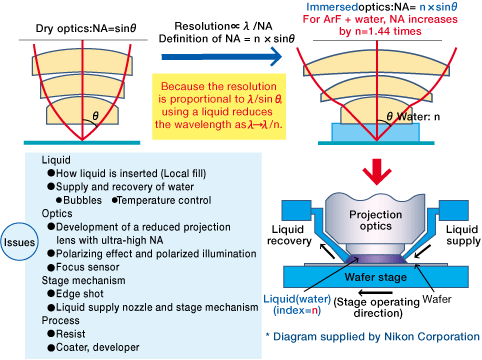
Principy imerzní litografie - zvýšení refrakčního indexu dovoluje dosáhnout podstatně vyšších hodnot NA a tím vyššího rozlišení (NA se v současnosti pohybuje do 1,35 pro vodu, teoretické limity se pro budoucí kapaliny pohybují až okolo 1,55); oproti "suché" DUV se numerická apertura zvýšila více než 1,4x , zdroj: Nikon
Opět zde musím zmínit kromě Nikonu i firmu ASML, která je jednoznačným lídrem v oblasti systémů pro imerzní i suchou fotolitografii. ASML v současnosti již nabízí zařízení pro imerzní litografii s použitím dalších technologií jako je HydroLith (postup u ponořené litografie kdy zařízení řady TWINSCAN s DUVi měří a zaostřuje wafer v "suché" pozici před pokrytím waferu kapalinou a dovoluje tak těžit z výhod zpracování waferů "mokrou cestou" se špičkovou přesností a vysokým výstupem WPH, téměř na úrovni klasické DUV s low k1. V textu dále označován jako index k, respektive k1 (neplést s Low-k nebo low-k materiálem s nízkou dielektrickou konstatou), kde je pomocí technik, jako je ozařování pomocí dipólu (šestipólu nebo prstence), tento index dále snižován.
Index k
se v současnosti u špičkových komerčně dostupných zařízení pro DUV fotolitografii pohybuje na úrovni okolo 0,3.
DUV a její budoucnost
Použití 193nm vlnové délky je tedy zatím faktem, který by před řadou let pro 32 nm výrobní technologii, a zřejmě i pro následující generaci, předpokládal málokdo. Vývoj DUV nyní přirozeně probíhá i v oblasti optiky pro litografická zařízení, kapalin a fotorezistů. Pro vývoj a možné nasazení DUVi jsou nejvhodnější kapaliny, které mají co nejvyšší refrakční index n a zároveň nepohlcují použité záření s 193nm vlnovou délkou. Hloubka ostrosti ovlivňuje možné zaostření a s imerzní litografií při stejném NA je zde vyšší tolerance na možné rozostření. Při nedostatečné toleranci nebo nedokonalému zaostření vznikají při výrobě a osvěcování nepřesnosti a vady.
Pro nasazení i u další generace výrobní technologie tedy bude nutné dále zvyšovat
refrakční index
n a ještě dále zvýšit
numerickou aperturu
NA. Třeba bude také použít lepšího fotorezistu (musí mít obdobný refrakční index jako použité médium, které vyplní vzdálenost mezi čočkou a waferem) a použít dokonalejší kapaliny, kde je navíc potřebný nízký absorbční koeficient (typicky pod 0,2-0,4 cm-1 / pro superčistou vodu a vlnovou délku 193 nm je pod 0,04 cm-1). Prakticky se čistota, respektive znečištění vody pohybuje v jednotkách ppt (pg/ml a absorbční koeficiant deionizované vody až okolo 0,01 cm-1). Další zlepšení samozřejmě může přinést lepší optika a ještě dokonalejší čočky u fotolitografických zařízení. K nejvěším dodavatelům zde patří divize pro litgorafii Carl Zeiss SMT (včetně zrcadel pro budoucí EUV).
I přes všechna zlepšení na dosažení 32 nm mety bude třeba častěji použít i techniku dvojité expozice - ta patří mezi stále častěji používané metody. Pomocí úpravy zdrojových masek a ozařováním dipólem s opakovanou expozicí (pomocí více fotolitografických masek), je tak možné tvořit struktury s ještě vyšším rozlišení. Pro vytvoření jediné vrstvy je ale díky tomu třeba dvojnásobný počet litografických masek a WPH se prakticky sníží na polovinu (díky nutné opakované expozici, vyleptání nechráněných struktur, odstranění fotorezistu a tak dále). S rostoucím rozlišením ale dochází s ozářením fotoresistu přes fotolitografickou masku k čím dál větším nepřesnostem, a po vyleptání struktury ztrácí požadovaný tvar. To je také důvod, proč se používají různé metody SMO (úpravy fotolitografických masek), kde tyto korekce zmíněné nedostatky potlačují.
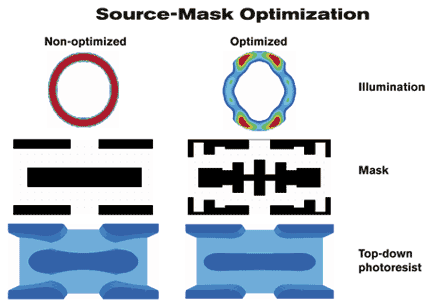
Metoda optimalizace zdrojových masek (SMO) - všiměte si změny "vysvícení" na fotoresistu, zdroj: ASML
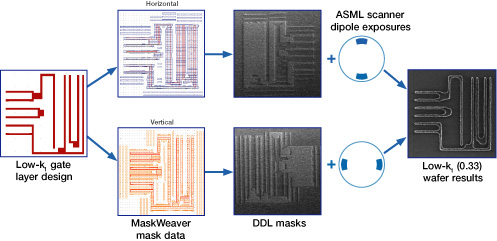
Dvojité ozařování pomocí dipólu a optimalizace masek pro nízké hodnoty k1 (na vytvoření jediné vrstvy jsou potřeba dvě fotolitografické masky), zdroj: ASML
Na DUV vsadí pro příští dvě generace výrobní technologie i IBM. Od 45 nm se běžně používá imerzní fotolitografie a stejně tomu bude i u 32 nm výrobní technologie. Ačkoliv vývoj a výzkum probíhá prakticky u všech výrobců polovodičů (často pod záštitou jedné či několika větších firem), roadmapy větších hráčů se zpožděním přebírají i další výrobci. Podle současných předpokladů IBM nebude EUV možné masově použít ani pro 22 nm, a tak i zde nakonec bude použita DUV - zařízení pro EUV nemusí být dostupná s odpovídajícím výkonem (nebo bude na úrovni možností DUVi), ale za cenu výměny většiny technického vybavení ve stávajících FABech. Proto IBM podle posledních prohlášení vsadí na imerzní fotolitografii. Situace se samozřejmě může ještě změnit, ale pokud nemá dojít odkladu zavádění nových technologií, firmy musí volit uvážlivě, ale zároveň včas. Podívejme se na to, co si o tom myslí ASML, jako největší dodavatel zařízeních pro litografii.
| Požadovaný index k1 vzhledem k NA a vlnové délce použitého záření | |||||||
| Half-pitch [nm] ~ výrobní technologie | 65 | 45 | 32 | 22 | 16 | 11 | |
| Rok uvedení | 2005 | 2007 | 2009* | 2011* | 2013* | 2015* | |
| λ [nm] | NA | k1 | k1 | k1 | k1 | k1 | k1 |
193 | 0,93 | 0,31 | - | - | - | - | - |
193 | 1,20 | 0,40 | 0,28 | - | - | - | - |
193 | 1,35 | - | 0,31 | 0,22 | 0,15 | - | - |
193 | 1,55 | - | - | 0,26 | 0,18 | - | - |
13,5 | 0,25 | - | - | 0,59 | 0,41 | - | - |
13,5 | 0,35 | - | - | - | 0,57 | 0,41 | - |
13,5 | 0,45 | - | - | - | - | 0,53 | 0,37 |
* - předpokládané nasazení EUV/DUVi dle ASML (jak již zaznělo v úvodu, k1 se v současnosti pohybuje okolo 0,3 a pro menší výrobní technologie ho s DUV bude třeba ještě dále podstatně snížit a bude nezbytné také použití high-n kapalin), zdroj: ASML
Na 32 nm není pro DUVi problém dosáhnout, a je s ní proto počítáno i pro 22 nm výrobní technologii, ale techniky pro zvýšení rozlišení (jako jsou zmíněné metody dvojité expozice) a to i přes další nárůst ceny a snížení výstupu, budou nevyhnutelné a doslova "denním chlebem". Mimochodem, pokud se naplní prognóza ohledně DUVi a 22 nm, bude 193 nm vlnové délce (ač s řadou inovací) bez problému patřit rekord v nejdelším nasazení vzhledem ke generaci výrobních technologií (v tomto případě 6 generací, od 130 do 22 nm), což je s přehledem nejvíce za celou historii fotolitografie...
Ačkoliv je tedy hromadné nasazení imerzní litografie před použitím EUV ta nejschůdnější cesta, bohužel i její nasazení má své stinné stránky. Odhaduje se, že z hlediska samotné "morkré" fotolitografie a nutných investic tak například Intel se "suchou" DUV ušetří přibližně 30 procent nákladů (spojených se zaváděním DUVi při 45 nm výrobní technologii). S DUVi samozřejmě experimentuje i Intel, ale AMD nebo IBM a řada dalších firem budou již mít s komerčním nasazením imerzní litografie bohaté zkušenosti. V případě, že se povede implementovat řadu nových materiálů a vyřeší se potíže se SOI u 22 nm a menších výrobních technologií (vzhledem k zatím nedosažitelným parametrům oproti ITRS roadmapě to minimálně nebude snadné), bude cesta pro 22 nm s DUVi připravená. Mezi další firmy, které přijímají DUVi patří například Samsung, Toshiba nebo TSMC. Pojďme se dále podívat, jak je na tom v současnosti EUV.