Technologii Intel Foveros známe už pár měsíců, ale od prvního představení se už o ní moc nemluvilo. Nyní se však už můžeme podívat na to, jak budou vrstveny čipy Lakefield, na Sunny Cove i na grafiku 11. generace.
Lakefield tak budou SoC firmy Intel využívající technologii Foveros, která bude využita pro vrstvení různých čipů na sebe, čímž se může ušetřit místo, ale především se pak budou moci spojovat různé čipy tvořené různými technologiemi a obejít se neblahé důsledky zvětšování monolitických čipů.

Právě Lakefield budou první, které Intel tímto způsobem postaví a umožní na jejich základě vytvořit počítače či jiná zařízení zcela nových formátů. Však se podívejme na to, o co se jedná.
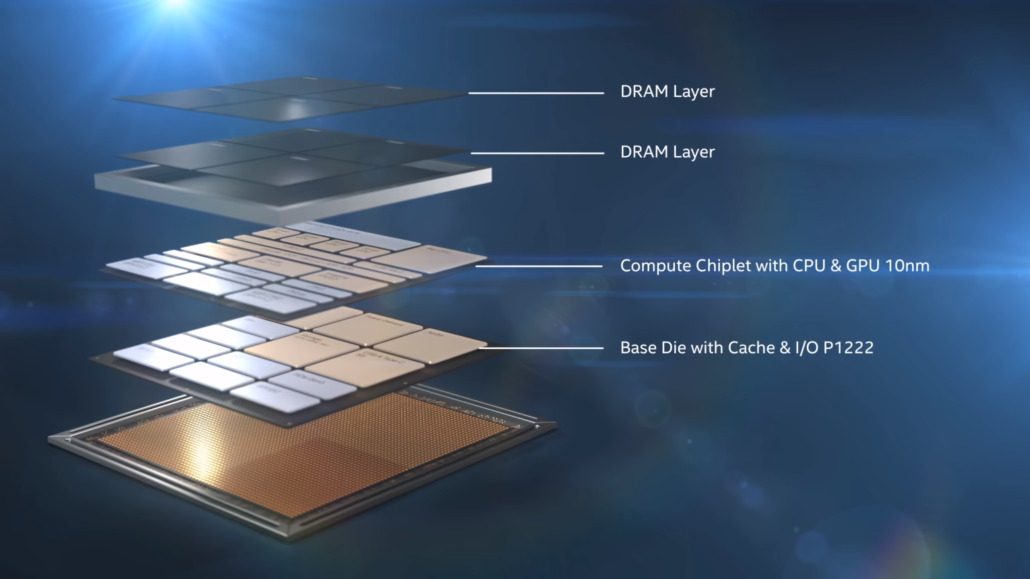
Obrázek jasně ukazuje na základní platformu, na niž budou naneseny čtyři vrstvy. První bychom mohli označit za spojení čipsetu a některých dalších podružných částí procesoru, v jejichž případě není třeba využívat nejmodernější výrobní proces, což bude i společná cache pro druhou vrstvu s 10nm CPU a GPU. Pak tu máme dvě vrstvy pamětí DRAM, jež budou odděleny nejspíše nějakým heatspreaderem, který bude mít za úkol efektivně odvést teplo dvou spodních vrstev do chladiče. Jak je vidět na vrchním obrázku, tento kus bude tvarovaný jako malá hranatá vana, v níž budou sedět paměťové čipy a skrz její široké okraje bude vedeno teplo do chladiče. Nějaké by ale mělo prostoupit také skrz paměti, ale je logické, že chlazení bude potřebovat především vrstva s CPU a GPU.
Každá vrstva je se sousedními propojena pomocí FTF mikro spojů na svůj aktivní interposer, takže první dvě vrstvy jsou v podstatě dvojité a celé pouzdro pak propojují TSV, čili vertikální spoje (Thru-Silicon Via). Celé SoC pak má rozměry pouze 12 x 12 mm, čili 144 mm2, což je srovnatelné s low-endovým GPU, a to může přitom tvořit až na úložné zařízení v podstatě celý systém a evidentně nijak slabý. Musí nás ale hned napadnout, jak složité a nákladné bude to všechno dát dohromady. Však klasické procesory jsou prostě křemík na substrátu, kdežto zde máme čtyři vrstvy čipů, z nichž dvě jsou samy o sobě dvojvrstvé a pak je tu ještě prostřední vodič tepla, skrz nějž budou muset jít také datové a napájecí spoje.
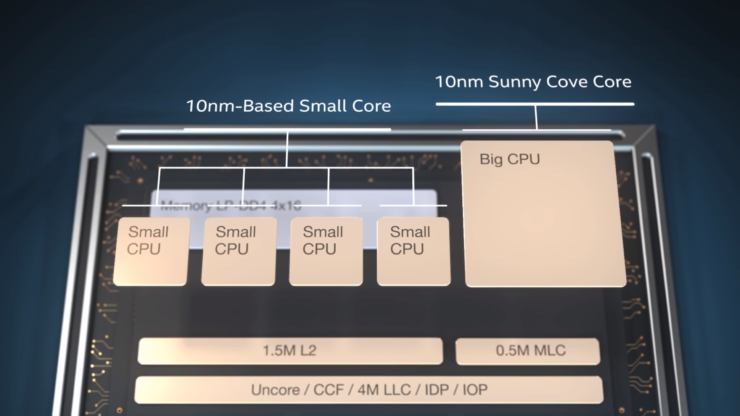
Ale uvidíme brzy, protože Intel chce vyrábět Lakefield ještě letos. Zajímavá bude také samotná CPU část skládající se z pěti samostatných jader, z nichž jedno je označeno za Big Core architektury Sunny Cove. To je stejná architektura, jakou očekáváme od 10nm procesorů Ice Lake. Zbyla čtyři jádra označená za Small CPU mají vykonávat relativně nenáročné operace, což nám může připomenout architekturu ARM big.LITTLE. Na stejném čipu pak bude grafické jádro 11. generace se 64 Execution Unit (EU), o jehož výkonu si už můžeme udělat představu. Lze pak očekávat, že obdoba samostatné eDRAM grafiky Iris Plus bude v nejspodnější vrstvě založené na 22nm procesu FinFET. To vše ukazuje následující video.
Vypadá to, že Intel se probudil.




















